新闻资讯
News
02
2025
-
09
人工智能赋能逆向光刻技术
作者:
计算光刻技术通过优化工艺因子提升分辨率。其中,逆向光刻技术凭借全局优化特性,备受学术界和产业界关注。近年来,人工智能技术的融合为逆向光刻带来了新突破,在光刻建模、掩模优化等环节发挥作用。
近期,来自清华大学的研究团队以“Advancements and challenges in inverse lithography technology: a review of artificial intelligence-based approaches”为题在Light: Science & Applications发表论文,对人工智能驱动的逆向光刻技术进行综述。文章总结了逆向光刻技术的基本原理与发展历程,分析了人工智能技术在逆向光刻中的应用。文章指出了逆向光刻技术面临的挑战,并展望了发展方向。
本文的通讯作者为清华大学曹良才教授,第一作者为清华大学杨艺欣博士生。清华大学王琛副教授、刘珂瑄博士生和高云晖博士生对论文有重要贡献。
计算光刻
光刻工艺的主要步骤包括涂胶、前烘、曝光、后烘、显影、刻蚀、去胶和检测等(图1)。光刻曝光系统包括接触式、接近式和投影式,接触式曝光存在掩模污染和损伤问题,接近式曝光的精度受限于硅片平整度。1973年投影式光刻机问世,通过掩模图案的空间投影实现了图形转移。
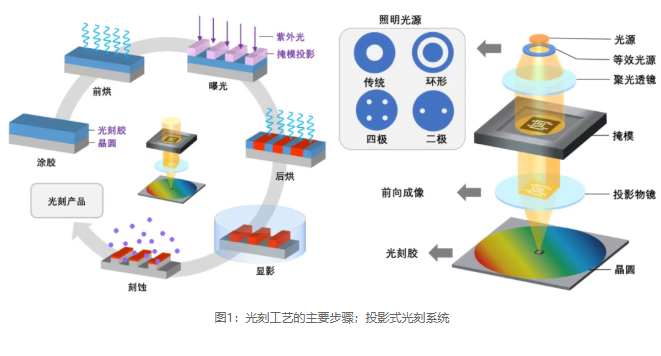
光刻分辨率增强技术包括离轴照明、光学邻近效应修正、相移掩模等。计算光刻技术对光刻的成像过程建模,根据目标晶圆图形,计算优化照明光源和掩模设计(图2)。

计算光刻发展主要阶段包括:基于规则的邻近效应修正、基于模型的邻近效应修正、逆向光刻技术(图3)。逆向光刻技术基于光刻系统模型,基于霍普金斯理论和传输交叉系数描述光学成像过程,通过梯度算法求解优化问题,使预测晶圆图形最大限度接近目标图形。

逆向光刻技术研究进展
1981年,威斯康星大学麦迪逊分校的研究者提出像素级掩模优化方法。2003年,Luminescent Technologies公司实现逆向光刻的工业应用,随后英特尔等企业推动加速逆向光刻的商业化进程。2010年,正则化框架和共轭梯度等算法的引入,提升了逆向光刻的计算效率。2017年,深度学习技术的融合开启了逆向光刻发展的新阶段,阿斯麦等公司采用卷积神经网络加速优化流程,图形处理器GPU等平台促进了逆向光刻技术的应用。历经四十余年,逆向光刻从理论构想逐步发展为半导体制造的关键技术(图4)。

图5展示了逆向光刻的掩模优化结果。计算光刻中可以采用多种照明光源模式,包括传统照明、环形照明、四极照明以及水平/垂直方向的偶极照明。以目标图案THU作为输入掩模进行优化设计。可以看出,初始光刻胶图案在晶圆上表现出明显的光学邻近效应,导致图形特征失真。经过逆向光刻算法优化后,获得的掩模图案使光刻胶图形质量得到改善,图案保真度明显提升。在不同照明条件下,价值函数的收敛情况有所不同,展示了逆向光刻算法的有效性和稳定性。
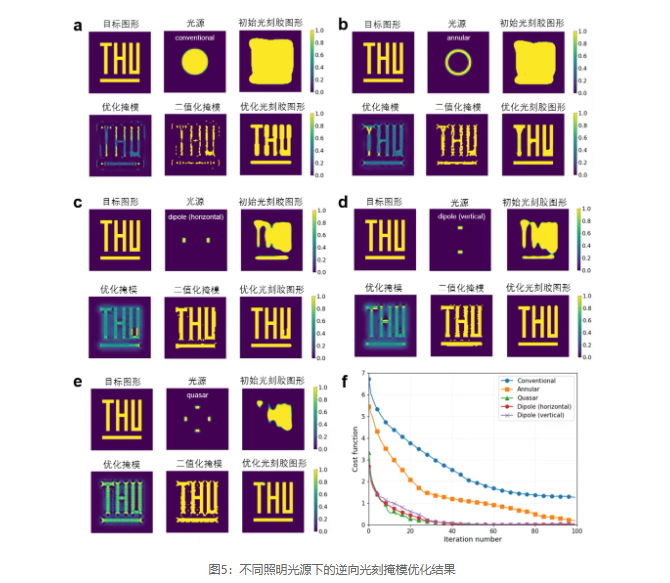
最新动态
感谢您访问崇帆科技官方网站,如有合作意向或建议,请通过以下方式联系我们,我们会尽快给予回复,谢谢!
移动版

官方公众号
